近日,我院龙世兵教授课题组在DRAM ZrO2介质电容器可靠性研究方面取得新进展。针对DRAM电容厚度微缩带来的介质可靠性问题,提出通过添加铝掺非晶保护层的设计策略,阻断了电容器在电压偏置时产生的氧空位导电细丝,改善介质经时绝缘击穿特性(图1)。该工作为进一步优化超薄锆基介电氧化物电容器提供了一种新的参考,相关成果以“Enhanced TDDB-Reliability of Ultra-Thin Zirconia Capacitors Featuring Al-Doped Oxide Layers”为题发表于电子器件领域知名期刊IEEE Electron Device Letters。
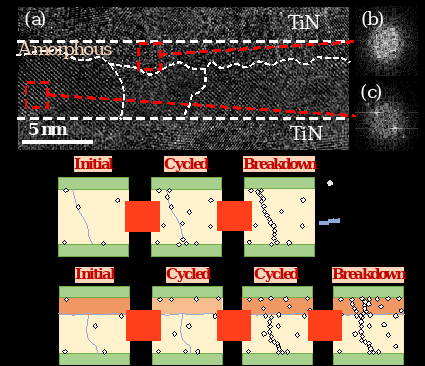
图1. (a) 高分辨率透射电子显微镜(HRTEM)下5.5 nm ZAZA薄膜横截面的图像,清楚地显示顶部非晶态AZA层和底部多晶ZrO2层。(b, c) 傅里叶变换后顶层 (b) 和底层 (c) 图像。(d) 锆基电容器的微观失效机理推演。顶部AZA保护层阻断了氧空位导电细丝的形成。
超薄氧化锆基介质系统具有如下优点:高介电常数、可调铁电性、适当的结晶温度,以及与CMOS制造技术的兼容性。这些特点使这一萤石结构氧化物电介质脱颖而出,已广泛应用于存储器、逻辑、和神经形态设备,尤其是动态随机存取存储器(DRAM)和铁电场效应晶体管(FeFET)。然而随着集成度的提高,锆基薄膜厚度逐渐降低,其可靠性问题逐步显现。
针对上述问题,研究人员在Si衬底上使用原子层沉积(ALD)技术沉积TiN底电极,而后生长超薄(<6 nm)锆基介质薄膜,再沉积TiN顶电极形成MIM电容器进行研究。对图形化后器件进行经时绝缘击穿(TDDB)测试,进一步对测试结果进行韦伯分布(Weibull)分析,统计推演出各个器件工作10年失效率小于0.01%的最高工作电场(ETDDB),详情可见图2。在5 nm薄膜中使用Al2O3/ZrO2/Al2O3(AZA)保护叠层,使其等效氧化物厚度(EOT)低至0.63 nm,同时ETDDB=4.18 MV/cm,其性能优于文献报道的其他器件。

图2. (a) 外推各锆基薄膜ETDDB,AZA保护层比例越大越能得到更好的TDDB特性。(b)比较本工作与其他锆基和铪基电介质,本工作ETDDB性能突出。
我院博士生唐心怡为论文第一作者,吕頔教授、龙世兵教授和长鑫存储技术有限公司白卫平高级工程师为论文通讯作者。此项研究工作得到了国家自然科学基金的资助,也得到了中国科大微纳研究与制造中心的支持。
文章链接:10.1109/LED.2024.3392331

